2025年2月18日
住友ベークライト株式会社(本社:東京都品川区、代表取締役社長:藤原一彦)は、2.xD/3D構造の次世代半導体パッケージ向け低弾性率基板材料の開発を開始しました。当開発品は、組立時、製品時での内部応力要因での故障を低減するもので、特にガラス基板を適用したパッケージにおいて、信頼性向上に貢献します。
開発の背景
昨今、生成AIの急速な普及に伴い、半導体の機能、構造、生産プロセスに大きな変革がもたらされています。2.xD/3D構造を始めとするAI向け半導体パッケージにおいて従来の有機基板と比較して、低熱膨張率や高弾性率、基板表面の平滑性といった特徴を持つガラス基板の適用が期待されています。
次世代半導体パッケージ用ガラス基板向け低弾性率基板材料
|
次世代半導体パッケージ用ビルドアップ材料は、パッケージ構造や生産プロセスに合わせて、反り制御、高密度実装、微細配線、高信頼性、高生産性を実現できる材料が必要とされています。当社は高い接続信頼性を期待できるガラス基板向けの低弾性率ビルドアップ材料の開発を開始しました。 当社が開発した低弾性率ビルドアップ材料を使用することで、パッケージ基板加工時の内部応力を低減することができ、加工時の衝撃によりガラス基板に発生した微小クラックや割れの拡大を低減することが期待できます。さらに従来当社材に比べて低誘電率、低誘電正接の機能を有しており、伝送損失に対する効果を得られます。 従来のガラスエポキシ基板でも適用可能で、顧客のパッケージ基板の構造や構成の自由度が増し、更なる機能の向上が見込めます。 |
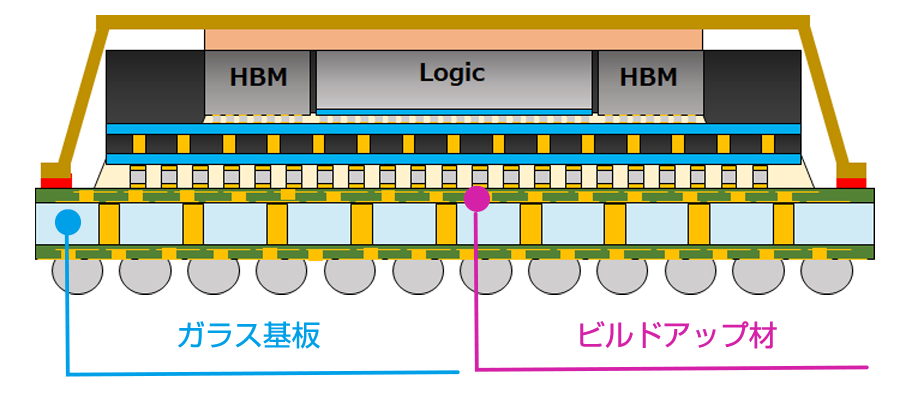
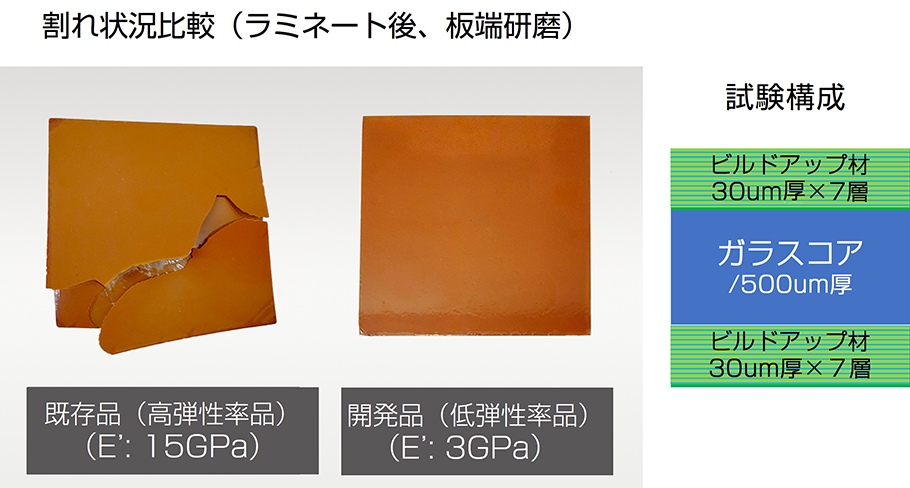
|
今後について
本製品は、2025年前半よりラボスケールサンプルとして顧客向け評価用に提供をおこなう計画です。
当社は市場や顧客のニーズに対応したパッケージ材料からAI向け半導体の高機能化や生産性の向上に貢献してまいります。
関連情報
本件に関するお問い合わせ
住友ベークライト株式会社 情報通信材料営業本部
TEL: 03-5462-4015