2024年5月31日
住友ベークライト株式会社(本社: 東京都品川区、代表取締役社長: 藤原一彦)は、世界で初めて3DS-TSVメモリ(シリコンビア接続3次元積層DRAM)に対応した圧縮成形用封止材樹脂(顆粒材)を開発しました。
本製品は既存の液状樹脂からの置き換えにより、顧客での生産性向上とAI市場の革新に貢献します。
開発の背景
近年、データ通信における高速・大容量・低遅延・高効率コンピューティングのニーズが高まっており、それに伴って半導体パッケージング技術に求められる軽薄短小化および高速化の要求も強くなっております。
半導体パッケージングの小型化の課題
半導体デバイスの小型化を図るための一つの方法として、メモリ半導体の3D積層技術(3D stacking)を実現するための技術として3DS-TSV(Through-Silicon Via)の採用が進んでいます。TSVは、シリコンウェハー上に穿孔された微細な穴で、複数の層を貫通しています。TSVを使用することで、複数の層を積層することが可能となり、デバイスの集積度が向上、より多くの機能を小スペースに収めることができます。またTSVを通じて電力供給が行われるため、電源消費が効率的になり、デバイスの省電力化が繋がります。
チップの積層間の狭いギャップを充填するために、粘度が低く小粒径のフィラーを配合出来る液状樹脂が採用されてきました。液状樹脂は、狭ギャップへの充填性が良好である一方で、パッケージ反りが大きい傾向や、生産性、コストが高いなど課題がありました。
3DS-TSV向け圧縮成形用封止樹脂について
|
当社は、狭ギャップ充填性とパッケージ反り改善の両立を目指し、技術開発を進めており、このたび5umカットフィラーを適用した圧縮成形用封止樹脂(顆粒材)を製品化しました。 技術のポイント
|
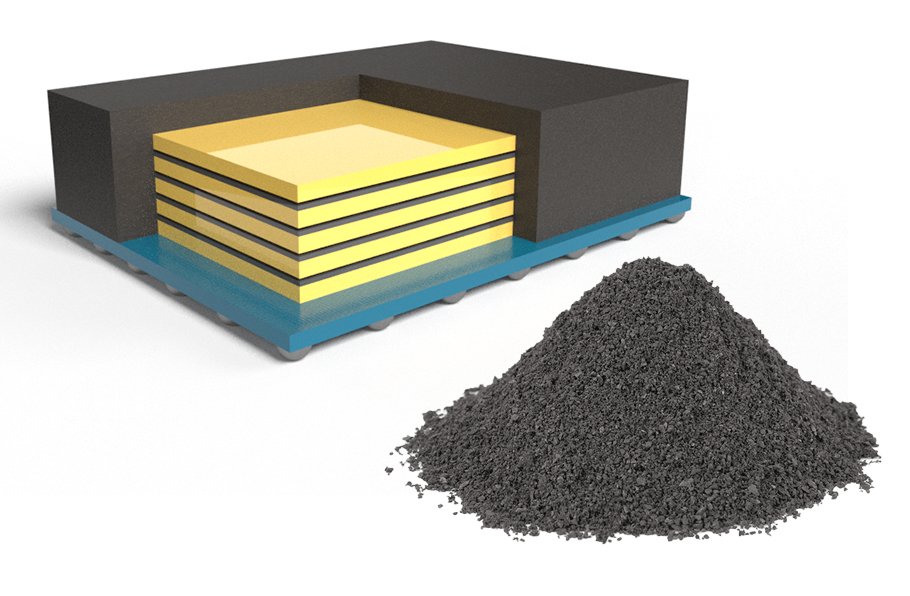
3DS-TSV向け圧縮成形用封止樹脂(顆粒) |
本製品は、2024年に大手メモリメーカーにて、3DS-TSVの量産立ち上げに使用開始される予定です。
TSV構造と技術ポイント
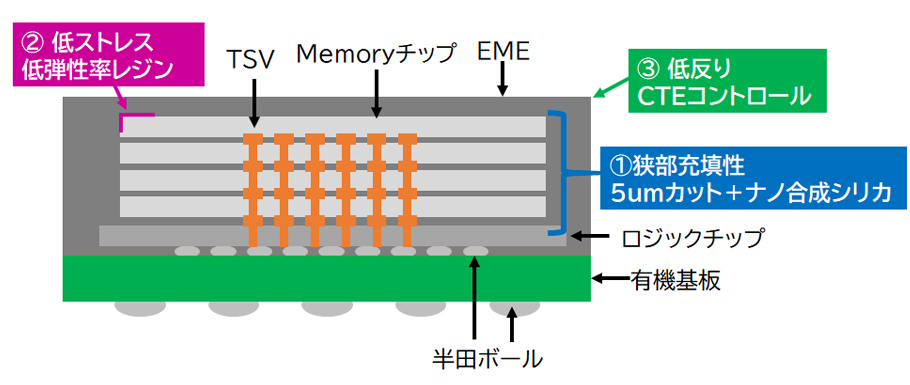
狭ギャップ充填向けEMEラインナップ
| フィラーカットサイズ (um) | 24 | 20 | 10 | 5 | ≦3 |
|---|---|---|---|---|---|
| 狭ギャップ部分充填向け EMEラインナップ | 量産中 | 量産中 | 量産中 | 量産中 | 開発中 |
現在、更なる狭Gapに対応した3umカット顆粒材を開発中です。
今後の計画
TSVは、3D積層技術において重要な役割を果たしており、高性能デバイスや高密度メモリに貢献しています。将来的には、より高密度なTSVの実現や新たな応用領域への展開が期待されています。
狭ギャップ充填向けEMEについては、お客様の評価を想定したサンプルの提供を開始いたします。
今後も当社は、TSVの更なる狭ギャップ化のニーズに対応した圧縮成形用封止樹脂の開発を進めてまいります。
関連情報
本件に関するお問い合わせ
住友ベークライト株式会社 情報通信材料営業本部
TEL: 03-5462-4015